
先進封裝基板技術_copy
IC封裝基板是半導體封裝的重要組成材料,用于搭載芯片,為芯片提供電連接、保護、支撐和散熱等。為實現3D-SiP的系統級集成需求,滿足未來5G、高性能計算機等高端應用的需求,業界對先進基板提出了提高布線密度、減小線寬線距、減小尺寸與重量,改善熱性能的要求。目前,先進封裝基板的研究方向主要有工藝改進、精細線路,以及倒裝芯片球柵格陣列封裝基板(FCBGA)、無芯封裝基板、有源無源器件的埋入基板等。
1.FCBGA(Flip Chip Ball Grid Array)
FCBGA是目前圖形加速芯片最主要的封裝格式。這種封裝技術始于20世紀60年代,當時IBM為了大型計算機的組裝,而開發出了所謂的C4(Controlled Collapse Chip Connection)技術,隨后進一步發展成可以利用熔融凸塊的表面張力來支撐芯片的重量及控制凸塊的高度,并成為倒裝技術的發展方向。
FCBGA的優勢有以下幾點:第一點是解決了電磁兼容(EMC)與電磁干擾(EMI)問題。采用Wire Bond封裝技術的芯片,其信號傳遞是透過具有一定長度的金屬線來進行,這種方法在高頻下會產生阻抗效應。但FCBGA用小球代替原先采用的針腳來連接處理器,采用這一封裝不僅提供優異的電性效能,同時可以減少組件互連間的損耗及電感,降低電磁干擾的問題,并承受較高的頻率。第二點是提高I/O的密度。一般而言,采用WireBond技術的I/O引線都是排列在芯片的四周,但采用FCBGA封裝以后,I/O引線可以以陣列的方式排列在芯片的表面,提供更高密度的I/O布局,產生最佳的使用效率,也因為這項優勢,倒裝技術相較于傳統封裝形式面積縮小30%至60%。第三點是基于FCBGA 獨特的倒裝封裝形式,芯片的背面可接觸到空氣,能直接散熱。同時基板亦可透過金屬層來提高散熱效率,或在芯片背部加裝金屬散熱片,更進一步強化芯片散熱的能力,大幅提高芯片在高速運行時的穩定性。

2.無芯封裝基板
根據是否有芯板,IC封裝基板可被分為有芯基板和無芯基板。它使用帶有雙面銅箔的聚酰亞胺(Polyimide,PI)作為基材,PI膜作為絕緣層,通過加成法實現高密度布線。無芯封裝基板厚度僅為傳統基板厚度的1/3,厚度降低,不僅使無芯基板更能適應消費類電子產品輕、薄、短、小的趨勢,還使它具有更高的信號傳輸速度、更好的信號完整性、更低的阻抗、更自由的布線設計、以及能夠實現更精細的圖形和間距等特點。但由于缺乏鋼性芯板的機械支撐,使得無芯封裝基板強度不足,易于翹曲。如何減少制造和裝配過程中的翹曲,成為無芯封裝基板研究和生產領域的重要課題。常見的降低無芯封裝基板翹曲的方法有:在半固化片中添加玻璃纖維以增加剛度,將基板表層電介質材料更換為剛度更強的半固化片,使用低熱膨脹系數電介質材料以降低Cu線路-電介質材料之間熱膨脹系數失配導致的翹曲,針對制程開發能夠減少翹曲的合適夾具,平衡基板各層覆銅率以減少上下層熱膨脹系數失配等。下圖展示的是一種無芯封裝基板制作方法。
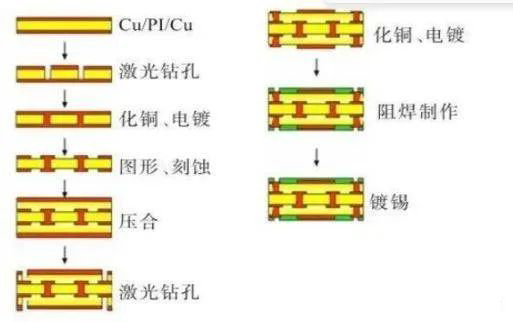
3.埋入式基板
根據埋入的元器件種類,可大致分為無源元件埋入、有源器件埋入以及無源、有源混埋技術和Intel的嵌入式多核心互聯橋接(Embedded Multi-die Interconnect Bridge,EMIB)技術。
3.1無源元件埋入基板技術
相比于傳統的、將元器件全部焊接至PCB板表面的技術,元器件埋入基板技術有四個優點。第一點是可以增加PCB設計布線的靈活性和自由度,而且可以減少布線和縮短布線的長度,從而大大提高PCB高密度化的程度。第二點是提高PCB組裝的高可靠性,通過這樣的工藝方法,極為明顯地減少PCB板面的焊接點,從而提高了組裝板的可靠性,大大地降低由于焊接點引起的故障率的幾率。第三點是改善PCB組裝件的電氣性能,這是因為將無源元件埋入到高密度化PCB中,消除了分立無源元件所需要的連接焊盤、導線和自身的引線焊接后所形成回路。第四點是非常明顯節省產品或PCB組裝件的成本。
3.2 有源器件埋入基板技術
按照芯片埋入的制程先后順序,有源器件埋入基板技術可分為芯片先置型(chip-first)埋入技術和芯片后置型(chip-last)埋入技術。芯片先置型埋入技術先將芯片埋入有機絕緣介質中,之后再制作電路圖形以實現信號傳輸和電源供應。芯片后置型埋入技術先制作build-up基板,在制作好的基板上開槽并制作好電路圖形,將芯片放置在槽中,實現電氣連接后再使用樹脂填充芯片與槽體之間的間隙。
與芯片先置技術相比,chip-last技術埋入的芯片位于基板的最上層,可返工且散熱更好,埋入芯片后沒有其他基板增層工藝步驟,加工良率更高。但是芯片先置技術也有其優勢,芯片后置技術埋入芯片只能埋入一層芯片,且埋入芯片的基板表面無法再貼裝器件,因此芯片先置技術對基板空間縱向利用率較芯片后置技術更好。
3.3EMIB技術
EMIB是將帶有多層導電金屬(Back End Of Line,BEOL)互連的超薄硅片埋入有機封裝基板的最上層,通過焊球與倒裝芯片的連接,以實現兩個或多個芯片之間的局部高密度互連。這種埋入式結構可被放置在有機基板的任意位置以實現超高密度局部互連,在遠大于典型掩膜版尺寸范圍內集成大芯片,使用非常靈活。下圖為EMIB技術結構示意圖。